ж¬ўиҝҺжқҘеҲ°зҰҸжҳҺ科жҠҖе“ҒзүҢе®ҳзҪ‘

е…ЁеӣҪз»ҹдёҖе’ЁиҜўзғӯзәҝпјҡ
0755-83280830




В· з”ЁйҖ”пјҡеҚҠеҜјдҪ“е°ҒиЈ…дё“з”Ёй”ЎиҶҸгҖӮ
Sn5Pb95пјҲзҶ”зӮ№308в„ғпјүпјӣ
Sn5Pb93.5Ag1.5пјҲзҶ”зӮ№296в„ғпјүпјӣ
Sn5Pb92.5Ag2.5пјҲзҶ”зӮ№287в„ғпјүпјӣ
Sn10Pb90пјҲзҶ”зӮ№275в„ғпјүпјӣ
Sn10Pb88Ag2пјҲзҶ”зӮ№268в„ғпјүпјӣ


дёҖгҖҒдә§е“ҒжҰӮиҝ°пјҡ
FMP-660жҳҜжң¬е…¬еҸёз”ҹдә§зҡ„дёҖж¬ҫй’ҲеҜ№еҠҹзҺҮеҚҠеҜјдҪ“е°ҒиЈ…з„ҠжҺҘзҡ„й«ҷй“…й”ЎиҶҸпјҢеҸҜж»Ўи¶іе®ўжҲ·зӮ№иғ¶е’ҢеҚ°еҲ·е·ҘиүәеҲ¶зЁӢгҖӮеҸҜеә”з”ЁдәҺеҠҹзҺҮз®ЎгҖҒдәҢжһҒз®ЎгҖҒдёүжһҒз®ЎгҖҒж•ҙжөҒжЎҘгҖҒе°ҸеһӢйӣҶжҲҗз”өи·Ҝзӯүдә§е“Ғе°ҒиЈ…з„ҠжҺҘгҖӮ
дәҢгҖҒдә§е“ҒдјҳзӮ№пјҡ
A.жң¬дә§е“Ғдё“й—Ёй’ҲеҜ№еҠҹзҺҮеҚҠеҜјдҪ“е°ҒиЈ…з„ҠжҺҘдҪҝз”ЁпјҢж“ҚдҪңзӘ—еҸЈе®ҪпјҢеңЁRoHSжҢҮд»ӨдёӯеұһдәҺиұҒе…Қз„Ҡж–ҷгҖӮ
B. еҢ–еӯҰжҖ§иғҪзЁіе®ҡпјҢеҸҜд»Ҙж»Ўи¶ій•ҝж—¶й—ҙзӮ№иғ¶е’ҢеҚ°еҲ·иҰҒжұӮгҖӮ
C. еҚ°еҲ·ж—¶пјҢе…·жңүдјҳејӮзҡ„и„ұиҶңжҖ§пјҢеҸҜйҖӮз”ЁдәҺеҫ®жҷ¶зІ’е°әеҜёеҚ°еҲ·0.2-0.4mmиҙҙиЈ…гҖӮ
D. еҸҜз„ҠжҺҘжҖ§еҘҪпјҢеңЁзәҝиүҜзҺҮй«ҳпјҢз„ҠзӮ№ж°”еӯ”зҺҮдҪҺдәҺ10%гҖӮ
E.ж®Ӣз•ҷзү©з»қзјҳйҳ»жҠ—еҸҜдҪңе…Қжё…жҙ—е·ҘиүәпјҢж®Ӣз•ҷзү©жҳ“жә¶и§ЈдәҺжңүжңәжә¶еүӮгҖӮ
F. з„ҠеҗҺз„ҠзӮ№йҘұж»ЎгҖҒе…үдә®гҖҒејәеәҰй«ҳпјҢз”өеӯҰжҖ§иғҪдјҳи¶ҠгҖӮ
G. дә§е“ҒеӮЁеӯҳжҖ§дҪіпјҢеҸҜеңЁ-жё©25в„ғдҝқеӯҳдёҖе‘ЁпјҢ0-10в„ғдҝқиҙЁжңҹдёә6дёӘжңҲгҖӮ
H. йҖӮз”Ёзҡ„еҠ зғӯж–№ејҸпјҡеӣһжөҒзӮүгҖҒйҡ§йҒ“зӮүгҖҒжҒ’жё©зӮүзӯүгҖӮ
дёүгҖҒйҖӮз”ЁиҢғеӣҙпјҡ
еҸҜеә”з”ЁдәҺеҠҹзҺҮз®ЎгҖҒдәҢжһҒз®ЎгҖҒдёүжһҒз®ЎгҖҒж•ҙжөҒжЎҘгҖҒе°ҸеһӢйӣҶжҲҗз”өи·Ҝзӯүдә§е“Ғе°ҒиЈ…з„ҠжҺҘгҖӮ
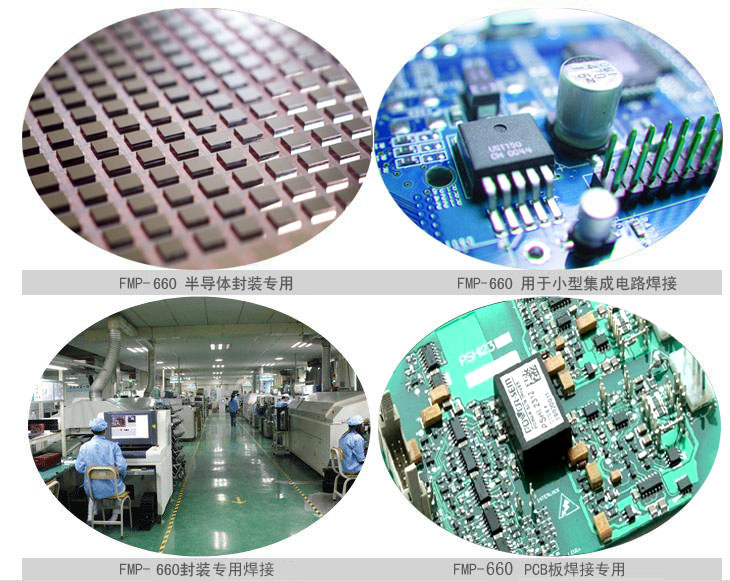



ж·ұеңіеёӮзҰҸжҳҺз”өеӯҗ科жҠҖжңүйҷҗе…¬еҸё
й”Җе”®зғӯзәҝпјҡ0755-83280830
24е°Ҹж—¶жҠҖжңҜе’ЁиҜўпјҡ18820272868
дј зңҹпјҡ0755-29036088
йӮ®з®ұпјҡdan@szfumen.com dcm@szfumen.com